
Instytutu Fizyki PAN
Opis
Technika osadzania warstw atomowych (ALD) jest odmianą metody chemicznego osadzania z fazy pary (ang. Chemical Vapor Deposition, CVD) i polega na naprzemiennym podawaniu gazowych reagentów (zwanych prekursorami) do komory reakcyjnej. Na podłożu w wyniku reakcji chemicznej jest osadzana warstwa danego materiału. Osadzanie materiału odbywa się w cyklach, z których każdy składa się z czterech etapów: podawanie pierwszego prekursora, przedmuchiwanie komory gazem obojętnym (N2), podawanie drugiego prekursora, przedmuchiwanie komory gazem obojętnym. Celem takiego przedmuchiwania komory jest usunięcie nieprzereagowanych resztek prekursora i produktów ubocznych reakcji chemicznych. W systemie ALD warstwy mogą powstawać na skutek reakcji syntezy, pojedynczej lub podwójnej wymiany chemicznej, w zależności od rodzaju zastosowanych prekursorów.
Parametry
- Posiadamy trzy reaktory ALD
- Temperatury wzrostu: 25 - 500oC
- Maksymalna wielkość podłoża: 20 cm średnicy
- Grubość warstwy: 10 - 3000 nm
- Tempo wzrostu: ~0.4 nm/min
- Jednorodne pokrycie dużych powierzchni
- Jednorodne pokrycie podłóż o bardzo rozbudowanej (trójwymiarowej) powierzchni
- Kontrolowany wzrost w skali nanometrowej
Zastosowania
Użycie metody ALD przez firmę Intel zrewolucjonizowało przemysł elektroniczny. Postęp w miniaturyzacji i wprowadzenie do produkcji trzech nowych generacji układów scalonych w standardach 45 nm, 32 nm oraz najnowszym 22 nm stało się możliwe dzięki wykorzystaniu technologii ALD do wytwarzania tlenków izolacyjnych. Metoda ta doskonale nadaje się do osadzania tlenków izolujących w strukturach elektronicznych (tj. tranzystory, pamięci półprzewodnikowe), warstw półprzewodnikowych oraz przezroczystych elektrod w urządzeniach elektronicznych i fotowoltaicznych, a także warstw o właściwościach ferroelektrycznych. Technologia ALD pozwala w kontrolowany sposób wzrostu otrzymywać warstwy monokrystaliczne, polikrystaliczne lub amorficzne.
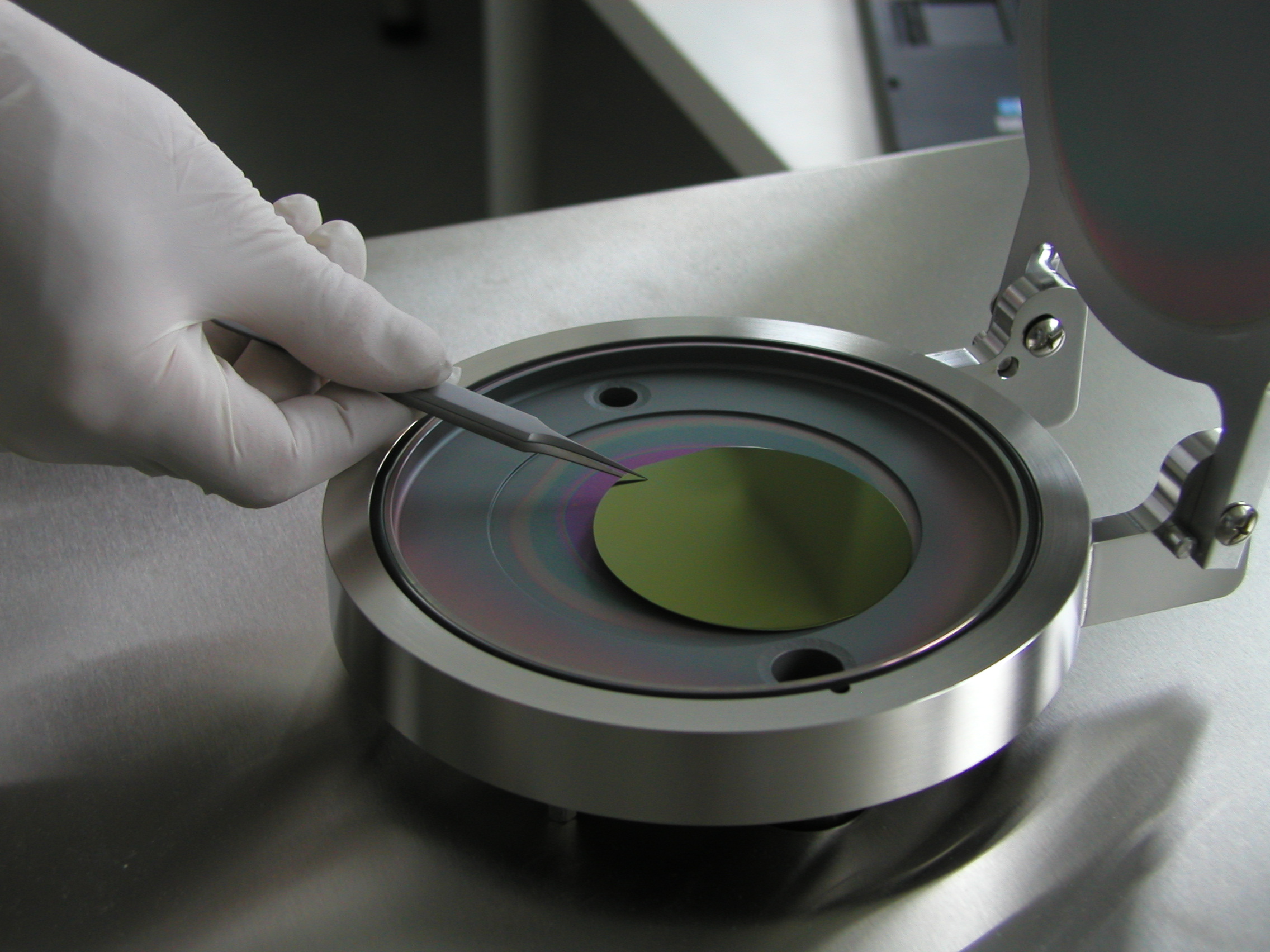
Jednorodna warstwa tlenkowa na krzemowym podłożu o średnicy 11 cm. |

Reaktor ALD (Savannah-100, Ultratech/Cambridge NanoTech) z komorą reakcyjną o średnicy 11 cm. |

Reaktor ALD (TFS 200, Beneq) z komorą reakcyjną o średnicy 22 cm. |
Instytut Fizyki Polskiej Akademii Nauk, Aleja Lotników 32/46, 02-668 Warszawa
tel.: (+48) 22 843 70 01 | fax: (+48) 22 843 09 26 | www.ifpan.edu.pl
NIP: 525-000-92-75, Regon: 000326061