
Instytutu Fizyki PAN
Opis
Warstwy izolujące wykonywane metodą osadzania warstw atomowych (ALD) na dowolnym podłożu (np.: Si, GaN, SiC, grafen, ZnO itp). Materiały powstają w procesie chemicznym w trakcie reakcji podwójnej wymiany z dwóch reagentów (prekursorów) takich jak prekursor tlenowy oraz prekursor metalu. Warstwy izolujące mogą składać się z jednego lub kilku materiałów tlenkowych. Związki są otrzymywane w niskiej temperaturze, najczęściej poniżej 100oC. Maksymalna wielkość podłoża wynosi 20 cm średnicy.
Parametry
- Materiały: Al2O3, TiO2, HfO2, ZrO2 i warstwy kompozytowe
- Grubość: 10 - 400 nm
- Kontrolowany wzrost w skali nanometrowej
- Tempo wzrostu: 0.1 - 0.2 nm/min
- Oporność: >108Ωcm
- Gęstość prądu upływu (1V): > 10-7 A/cm2
- Wytrzymałość dielektryczną: > 4 MV/cm
- Chropowatość powierzchni: 0.2 nm < RMS < 10 nm
- Przerwa energetyczna: > 3 eV
- Względna przenikalność elektryczna: 9 - 40
- Struktura: warstwy amorficzne
- Średnia transmisja w zakresie widzialnym: >80%
- Jednorodność pokrycia
Zastosowania
Osadzanie warstw dielektrycznych w temperaturze poniżej 100˚C umożliwia konstruowanie prawidłowo działających elementów elektronicznych zawierających izolatory w interakcji z różnymi materiałami półprzewodnikowymi takimi jak: Si, GaAs, ZnO, SiC, GaN, GaMnAs czy grafen. Przeprowadzone badania pokazały, iż najbardziej wydajnymi izolatorami są warstwy kompozytowe. Połączenie niskiej temperatury wytwarzania i przezroczystość warstw tlenkowych sprawia, iż elementy elektroniczne wykorzystujące te materiały, wykonane techniką ALD, stanowią solidną, realną, bezpieczną dla środowiska (brak działania szkodliwych związków) i bardzo obiecującą propozycję dla następnej generacji przezroczystej i elastycznej elektroniki.
Patent: PL395639 (13-07- 2011)
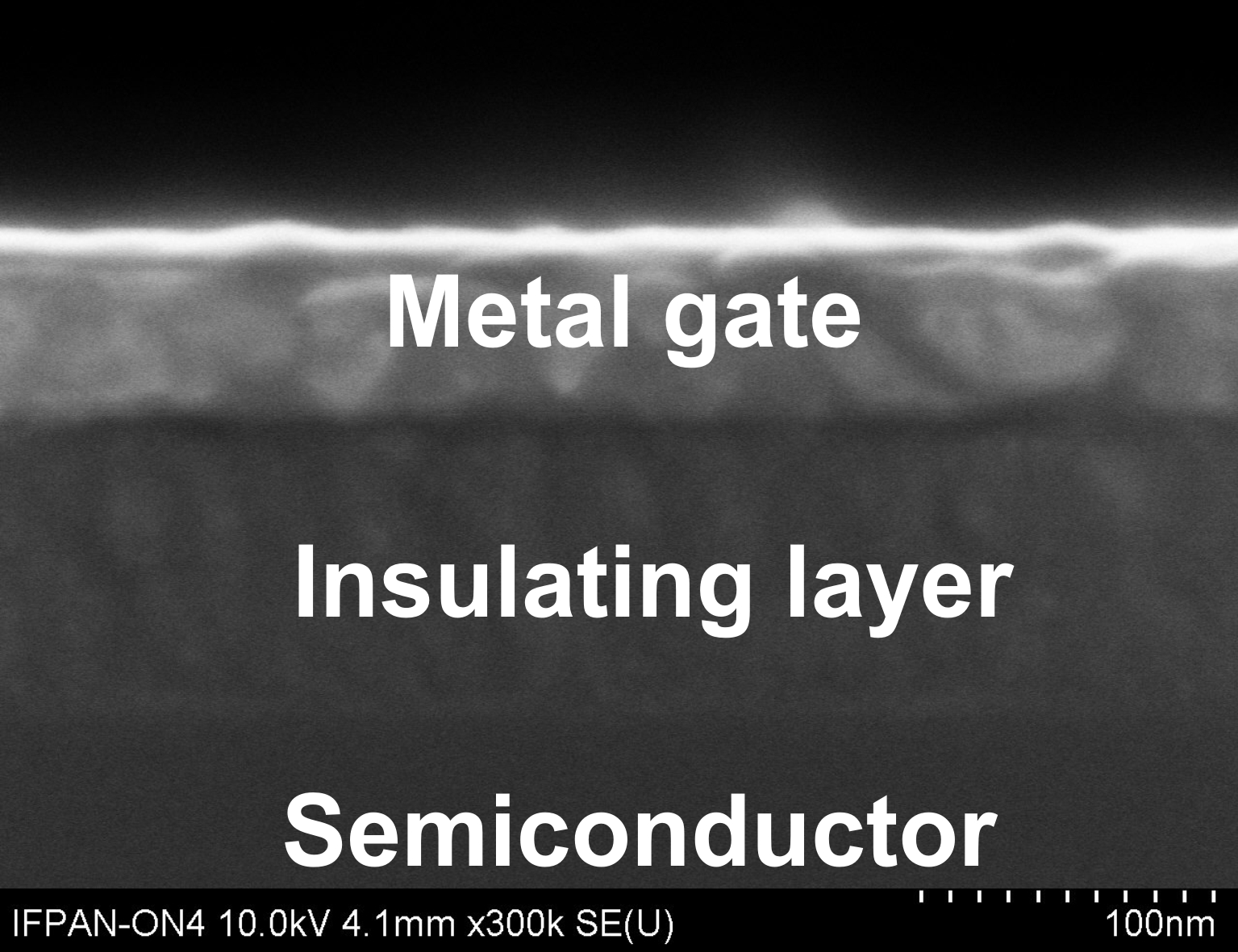
Przekrój poprzeczny struktury typu MIS (metal - izolator - półprzewodnik) z wykorzystaniem tlenkowej warstwy izolującej wykonanaej w niskiej temperaturze metodą ALD. |
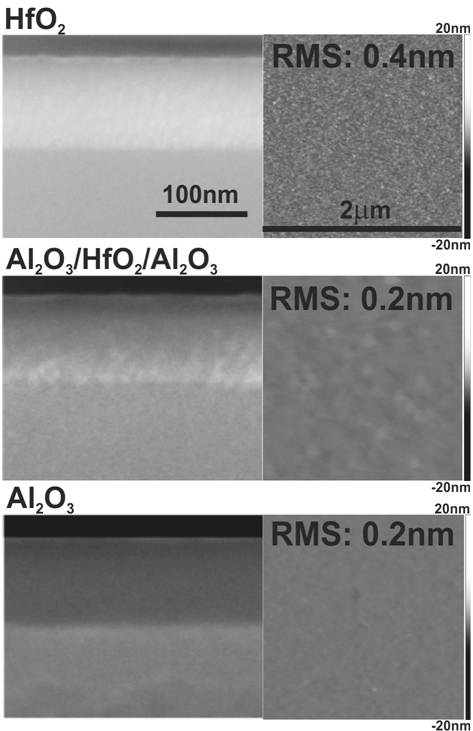
Przekroje poprzeczne (SEM) oraz skany powierzchni (AFM) wraz z wartościami RMS warstw izolujących: HfO2, Al2O3/HfO2/Al2O3 oraz Al2O3. |
Instytut Fizyki Polskiej Akademii Nauk, Aleja Lotników 32/46, 02-668 Warszawa
tel.: (+48) 22 843 70 01 | fax: (+48) 22 843 09 26 | www.ifpan.edu.pl
NIP: 525-000-92-75, Regon: 000326061