
Instytutu Fizyki PAN
Opis
Cienkie warstwy dwutlenku hafnu (HfO2) są wykonywane metodą osadzania warstw atomowych (ALD) na dowolnym podłożu (np.: Si, GaN, SiC, grafen, SiO2 itp). Materiał powstaje w procesie chemicznym w trakcie reakcji podwójnej wymiany z dwóch reagentów (prekursorów) takich jak woda dejonizowana (prekursor tlenowy) oraz tetrakis(dimetylamido)hafnium(IV) - TDMAH (prekursor hafnowy). Związek może być otrzymywany w zakresie temperatur od 70°C do 300°C. Maksymalna wielkość podłoża wynosi 20 cm średnicy.
Parametry
- Grubość: 10 - 3000 nm
- Tempo wzrostu: 0.2 nm/min
- Oporność: > 108 Ωcm
- Przerwa energetyczna: 6.2 eV
- Współczynnik załamania: 2.03 (635 nm)
- Względna przenikalność elektryczna: 21±3
- Właściwości hydrofobowe
- Chropowatość powierzchni: 0.4 nm < RMS < 30 nm
- Struktura: polikrystaliczna - faza jednoskośna lub warstwy amorficzne
- Średnia transmisja w zakresie widzialnym: >80%
- Jednorodność pokrycia
Zastosowania
HfO2 łączący w sobie pożądane parametry optyczne, elektryczne i strukturalne może być wykorzystywany jako izolator w urządzaniach elektronicznych, w szczególności w obszarze tzw. "przezroczystej elektroniki", jako materiał o zmiennej oporności w pamięciach elektronicznych, jako powłoki optyczne o wysokim współczynniku załamania w laserach i mikroskopach, a także jako warstwy barierowe czy zabezpieczające w strukturach fotowoltaicznych. Ponadto materiał ten może znależć zastosowanie w medycynie i stomatologii w procesie produkcji protez oraz implantów.

Zdjęcie przekroju poprzecznego warstwy HfO2 na krzemowym podłożu wykonane za pomocą skaningowego mikroskopu elektronowego (SEM). |
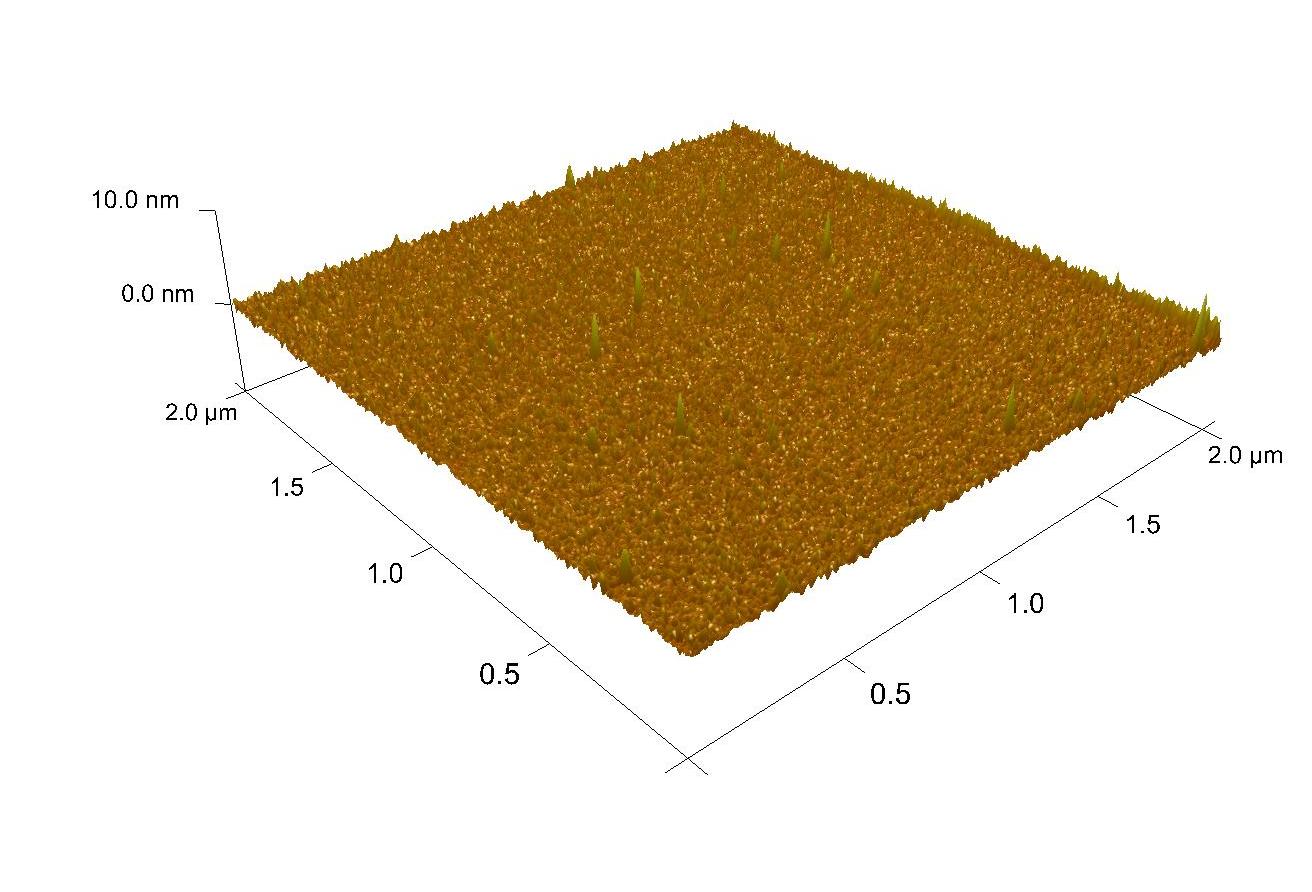
Obraz powierzchni dwutlenku hafnu (RMS: 0.4 nm) na krzemowym podłożu wykonany mikroskopem sił atomowych (AFM). |

Widmo dyfrakcji rentgenowskiej (XRD) polikrystalistycznych w fazie jednoskośnie i amorficznych warstw dwutlenku hafnu. Warstwy zostały osadzone na szklanym podłożu. |
Instytut Fizyki Polskiej Akademii Nauk, Aleja Lotników 32/46, 02-668 Warszawa
tel.: (+48) 22 843 70 01 | fax: (+48) 22 843 09 26 | www.ifpan.edu.pl
NIP: 525-000-92-75, Regon: 000326061